晶圆键合(Wafer Bonding)是半导体先进封装制程的关键工艺之一。晶圆键合界面若存在缺陷(如空洞、裂纹、分层等),会直接影响芯片的性能和可靠性,极大地降低产品的良率。由于晶圆键合的关键检测面处于晶圆之间,传统的检测手段往往难以满足高精度、高分辨率以及高速大批量的无损检测需求。

晶圆键合缺陷检测痛点
晶圆键合是将两片或多片晶圆通过物理或化学方法紧密结合的工艺。然而,键合过程中易产生多种缺陷,主要包括:空洞(bubble / Voids)、分层(Delamination)、裂纹(Cracks)、不均匀结合(Non-uniform Bonding)等。
这些缺陷通常位于键合界面内部,传统的光学检测(AOI)和X射线检测(X-Ray)难以精准识别。因此,超声波扫描显微镜成为了一种无损且高效的主流检测方案。
超声波扫描C-SAM/SAT技术优势
超声波扫描显微镜(C-SAM/SAT)技术通过高频超声波对材料内部结构进行成像。与其他无损检测技术相比,C-SAM/SAT技术在晶圆键合缺陷检测中具有以下显著优势:高分辨率成像、材料穿透能力强、完全无损检测、多层结构检测能力及定量分析能力等。
作为国内超声波技术的上市龙头企业,上海骄成超声波技术股份有限公司(以下简称“骄成超声”,股票代码:688392)推出了晶圆键合超声扫描检测系统(Wafer Level C-SAM/SAT),以超声波扫描显微镜(C-SAM/SAT)技术为核心,为晶圆键合缺陷检测提供了高效、精准的无损检测解决方案。
骄成超声晶圆键合超声扫描检测系统
骄成超声是一家专注超声波技术的国家专精特新企业,背靠上海交通大学,在超声波领域有近20年的技术积累,拥有有效知识产权350余项(其中发明专利70余项),实现全套超声波核心部件自研自供,构建起自主可控的超声波技术平台。

图1 骄成超声超声波技术平台
骄成超声晶圆键合超声扫描检测系统(Wafer Level C-SAM/SAT),包括全自动、半自动和离线式三种方案,适用于6、8、12寸晶圆键合检测。

图 2 骄成超声先进封装超声波扫描检测方案
骄成超声自主研发的晶圆超声波扫描显微镜,在扫描速度、检测精度、智能化程度等方面快速赶超进口设备水平,打破了先进高频超声波显微镜技术被国外品牌垄断的格局,可以对进口设备进行平替。
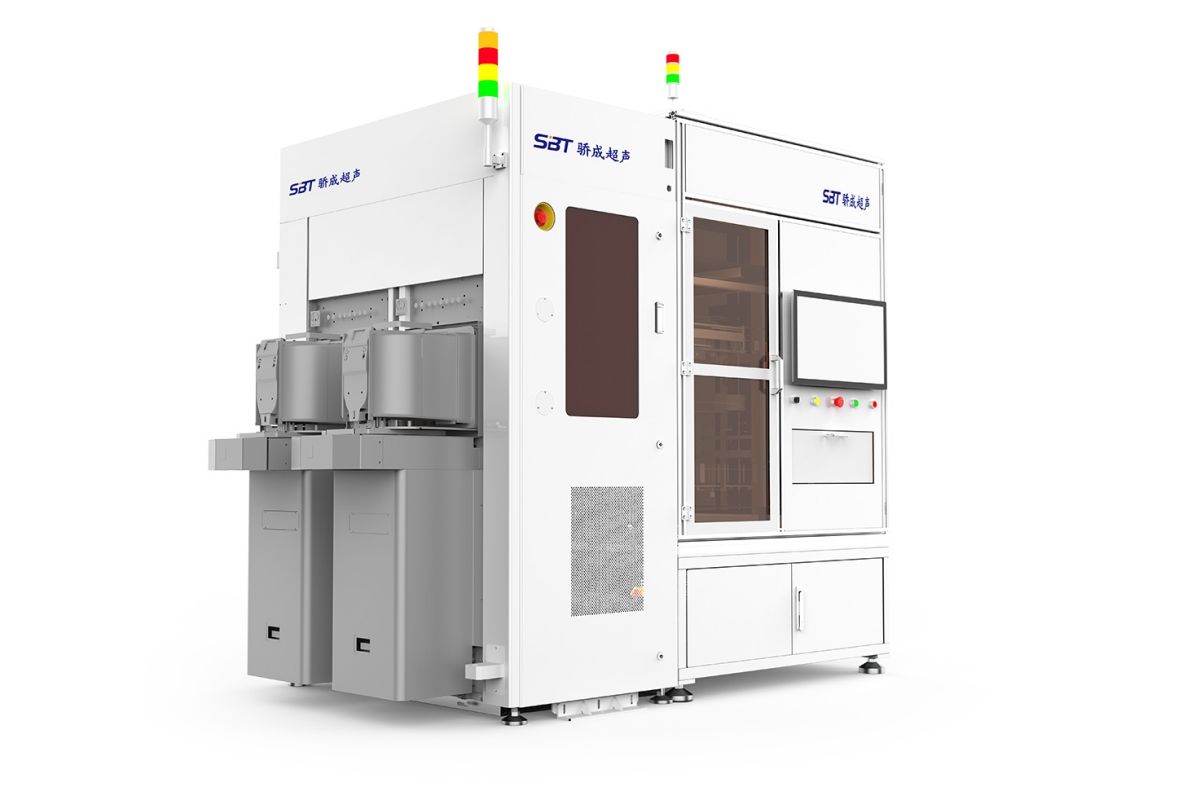
图3 全自动晶圆键合超声扫描显微镜Wafer 304
针对晶圆键合在线检测的需求,骄成超声推出了全自动晶圆键合超声扫描显微镜Wafer 304,其部分技术参数见下表:
表1 骄成Wafer 304-A设备参数

骄成Wafer 304-A技术特点
全自动、对接天车或AGV、自动巡边、烘干、连接EAP系统、支持多种探头和扫描模式,能够满足不同应用场景的检测需求。
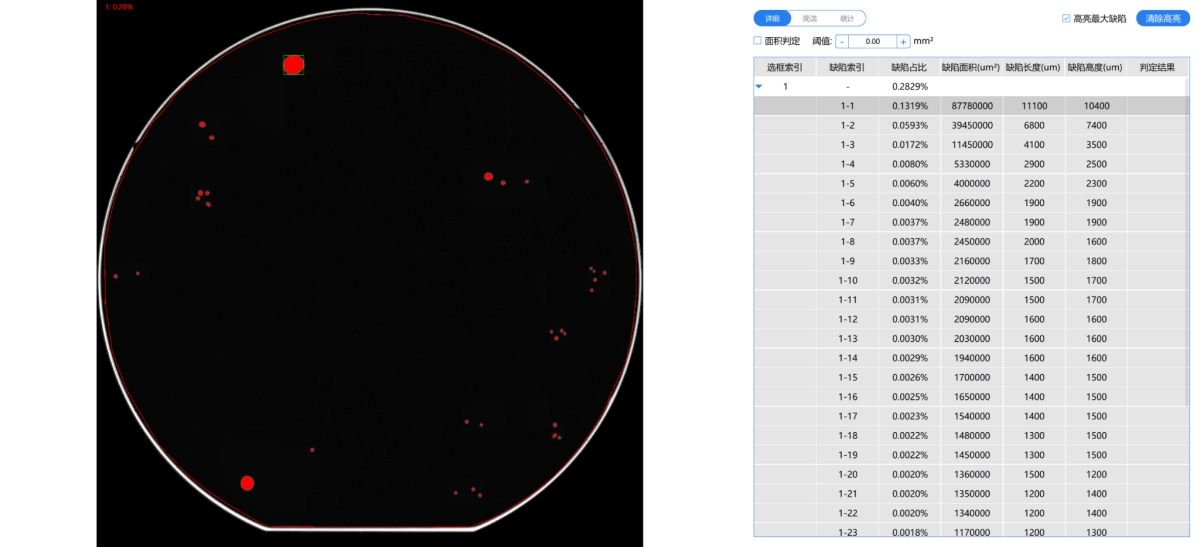
图4 检测案例
凭借优异的设备性能和技术服务,骄成超声晶圆键合超声扫描检测设备已成功获得国内知名客户验证性订单。
未来,骄成超声将继续深耕超声波技术,推动晶圆键合检测技术的进一步发展,为半导体行业提供更加高效、可靠的检测解决方案,助力先进封装技术的突破与创新。
注:[1] Sood S , Microtec S , Adams T ,et al.Acoustic Characterization of Bonded Wafers[C]//2008.DOI:10.1149/1.2982896.